在现代半导体封装工艺中,引线键合(Wire Bonding)技术作为一种关键的互连工艺,广泛应用于芯片与封装基板之间的电气连接。随着集成电路集成度不断提高,芯片引脚数量持续增加,引脚间距不断减小,这对键合工艺提出了更高的要求。等离子体处理已广泛应用于引线框架和基板在引线键合前的预处理,以增加引线键合的拉力强度和均匀性,提高可靠性。不断缩小的封装尺寸和相应的焊盘几何形状和间距的减小决定了键合表面必须妥善制备且无污染,以形成可靠的键合。
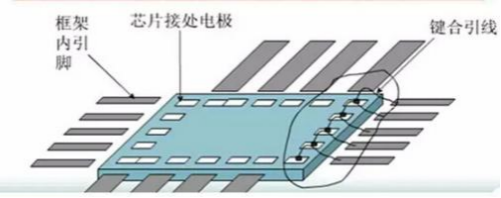
引线键合工艺概述
引线键合(Wire Bonding)目的:为了使芯片能与外界传送及 接收信号,就必须在芯片的接触电极与框架的引脚之间,一一个对应地用键合线连接起来。这个过程叫键合。
在半导体封装工艺流程中,引线键合是确保芯片与外部电路导通连接的关键环节,直接关系到封装产品的可靠性和性能。
引线键合中的主要挑战
随着半导体器件集成度的不断提高,引线键合工艺面临诸多挑战:
1.污染物影响:芯片和引线框架表面可能存在的各种污染物,包括有机物、金属离子、颗粒物等,会严重影响键合强度和可靠性。
2.表面活性不足:未经处理的材料表面通常具有疏水性和惰性,导致粘结性能差,容易在界面产生空洞,降低热传导能力。
3.精细结构要求:随着封装尺寸缩小,焊盘几何形状和间距减小,键合表面必须无污染且适当处理,以确保可靠的键合。
4.材料多样性:不同材料(如铜、铝、金等)的引线键合对前处理工艺有不同的要求,增加了工艺复杂性。
等离子清洗技术原理
等离子体是由正离子、负离子、自由电子等带电粒子和不带电的中性粒子(如激发态分子和自由基)组成的部分电离的气体。由于其正负电荷总是相等,因此被称为等离子体。这也是物质存在的第四种基本形态。
等离子清洗在引线键合前处理中的应用
等离子清洗在引线键合前处理中的应用主要体现在以下几个方面:
去除污染物:真空状态下的等离子作用能够基本去除材料表面的无机/有机污染,包括有机物、氧化物等。
提高表面活性:等离子清洗可以提高材料的表面活性,增加引线的键合能力,防止封装的分层。等离子清洗后,对工件芯片进行接触角测试,未进行等离子体清洗的工件样品接触角在82.8°;经过等离子体清洗后,接触角下降到17°。这表明等离子体清洗对封装中芯片的表面处理有显著效果。

等离子清洗技术相比传统的清洗方法具有以下优势:
1.环保性:等离子体清洗工艺中不使用任何化学溶剂,因此基本上无污染物,有利于环境保护。
2.处理范围广:等离子清洗的最大特点是不分处理对象的基材类型均可进行处理,对金属、半导体、氧化物、有机物和大多数高分子材料也能进行很好的处理。
3.清洗均匀性:等离子清洗具有良好的均匀性和重复性,清洗效果稳定可靠。
4.可控性强:等离子清洗的可控性强,可以根据不同材料和污染物选择合适的工艺参数。
5.提高键合强度:等离子清洗可以显著提高引线键合的拉力强度和均匀性,减少键合分离的风险,提高封装的可靠性和寿命。
6.减少缺陷:等离子清洗可以有效去除芯片和引线框架表面的污染物,减少键合过程中的缺陷,提高封装的良品率。
7.改善界面特性:等离子清洗可以改善芯片和引线框架之间的界面特性,提高粘结性能,减少界面空洞,改善热传导能力。

*片式真空等离子清洗机
等离子清洗技术作为一种先进的干法清洗方法,在半导体封装引线键合前处理中发挥着不可替代的作用。芯片在引线框架基板上粘贴后,要经过高温使之固化。如果芯片表面存在污染物,就会影响引线与芯片及基板间的焊接效果,使键合不完全或粘附性差,强度低。在引线键合前运用等离子清洗,会显著提高其表面活性提高键合强度及键合引线的拉力均匀性。



